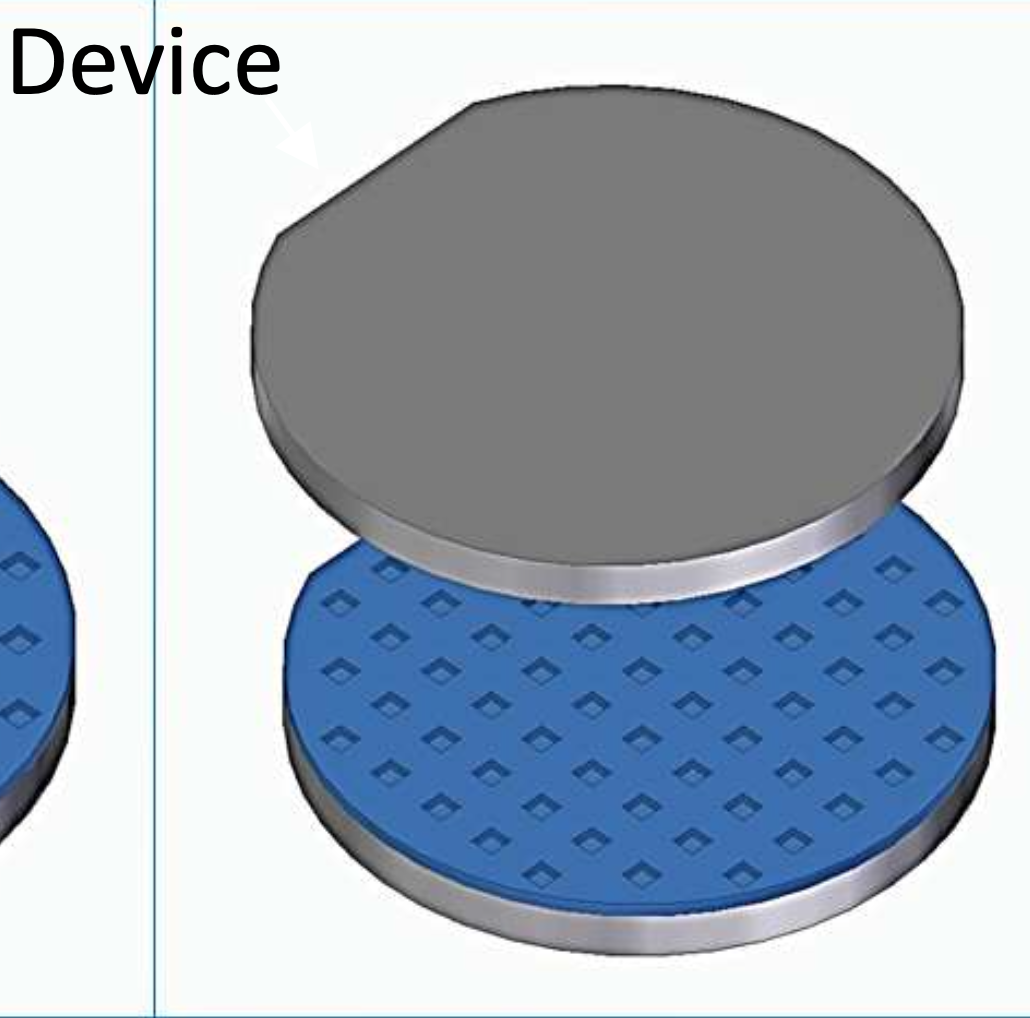
我们的空腔键合SOI解决方案使客户能够利用—
CSOI(Cavity-SOI,腔体SOI)是在SOI基础上又进一步发展而来的一种基底形式。CSOI是将器件原本需要背面刻蚀出的悬空结构,在SOI制造过程中就做进去,形成腔体的形式。
对于需要小孔径背腔释放的器件,例如PMUT来说,这是一个极大的工艺改良。相比于从SOI背 面进行数百μm的深硅刻蚀,一系列的刻蚀工艺会带来性能不稳定、一致性差异等问题。而CSOI 在底硅刻蚀的深度只有最多几十μm,工艺误差小,腔体陡直度高。并且由于制造过程的真空环 境,做出来的腔体也是真空密闭的。这对于需要隔离空气振动的声学应用来说,是天然的真空腔体。


CSOI的基本结构
CSOI的制造工艺前面的工艺和SOI相同,
(a.) 双抛硅晶圆。
(b.) 双面热氧。
(c.) 随后对埋氧层进行图形化,器件背面的腔体图形,包括对准标记都在此时完成图形化。
(d.) 接着刻 蚀底硅上层,由于刻蚀深度很小,通常在几μm到几十μm,因此其陡直度和开口尺寸的精度都得 以保证。后面的工艺就又和SOI相同了,
(e.) 顶硅晶圆的真空键合。
(f.) 减薄和抛光。
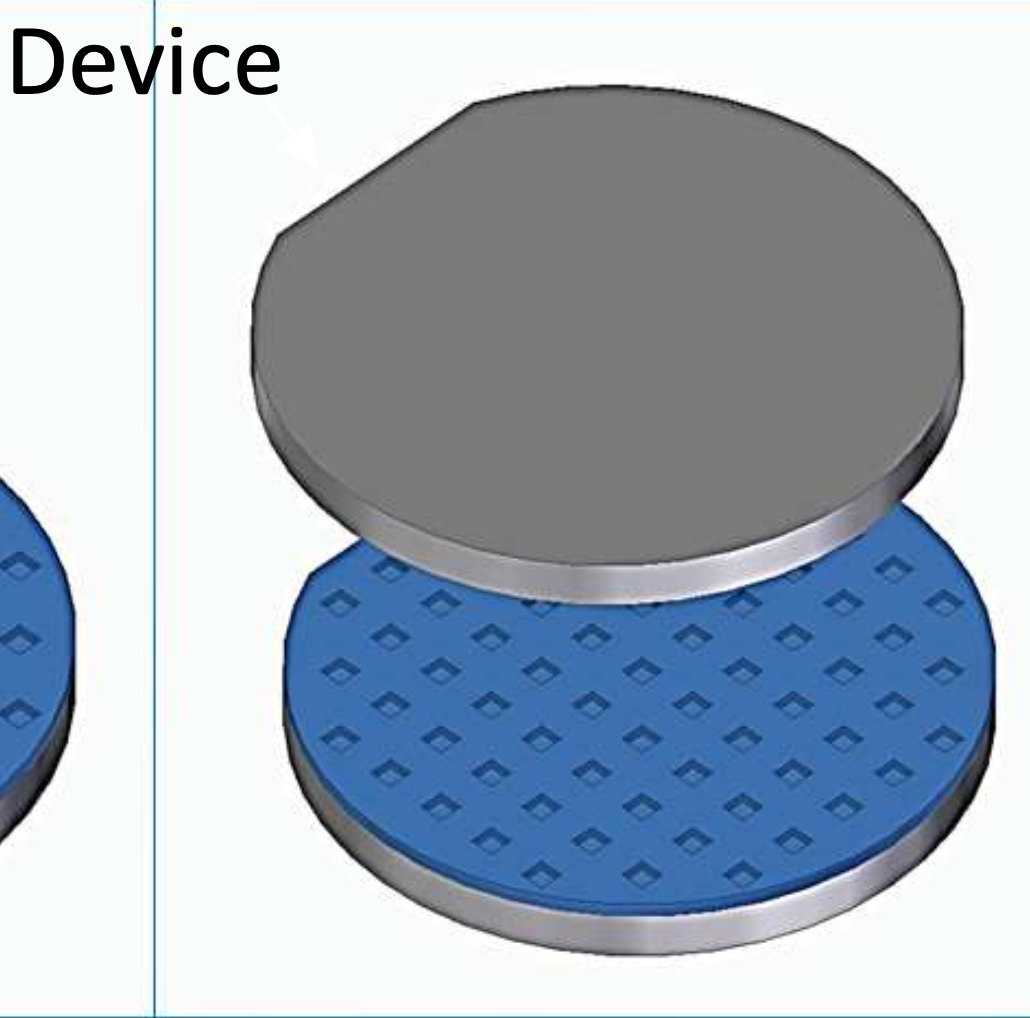

制造工艺流程
从制造过程可以看出,CSOI的腔体是做在底硅上的,而顶硅层是完整的。因此,这里可以得到 CSOI的另一个优点,在内部已做空腔的情况下,外部仍然保持整晶圆的完整性,这使得CSOI依 然可以作为生⻓各种材料的完整衬底。即使是PZT这样对衬底平整度、粗糙度要求较高的压电材 料,CSOI也兼容其制造工艺。
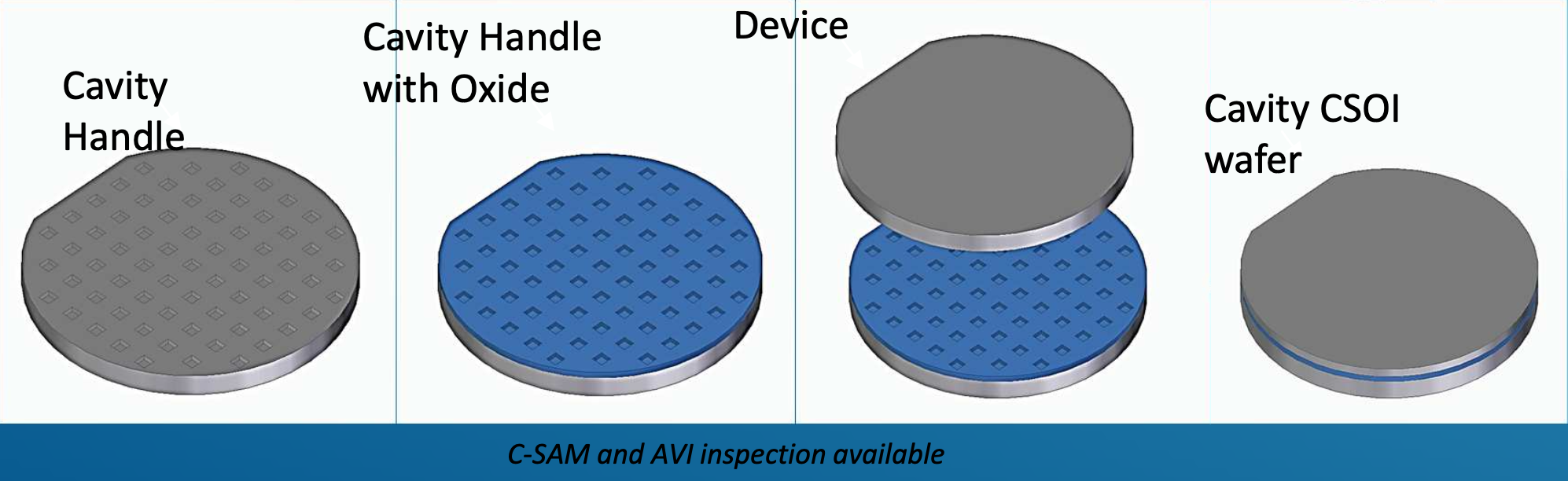
| Parameter | Specification Range |
| Wafer Diameter | 100, 125, 150 mm |
| Handle Layer Specifications | |
| Handle Thickness | 200–1100 µm |
| Handle Thickness Tolerance | ±5 µm |
| Stack Thickness | 280–1150 µm |
| Dopant Type | N or P |
| Doping | N type: Phos, Red Phos, Sb & As |
| P type: Boron | |
| Resistivity | ≤0.001 – ≥10000 Ω-cm |
| Growth Method | CZ, MCZ or FZ |
| Crystal Orientation | <100>, <111> or <110> |
| Backside Finish | Lapped/Etched or Polished |
| Buried Oxide Specifications | |
| Thermally Oxidised Buried OxideThickness | 0.2 – 4.0 µm grown on Handle, Device or both wafers |
| Device Layer Specifications | |
| Device Layer Thickness | ≥1.5 µm |
| Tolerance | ± 0.5 µm |
| Dopant Type | N or P |
| Doping | N type: Phos, Red Phos, Sb & As |
| P type: Boron | |
| Resistivity | ≤0.001 – ≥10000 Ω-cm |
| Growth Method | CZ, MCZ or FZ |
| Crystal Orientation | <100>, <111> or <110> |
| Buried Layer Implant | N type or P type |
| Membrane Thickness/SOI Thickness | >2 µm |
| Membrane Tolerance | ± 0.5 µm |
| Cavity Span: Membrane Thickness | <50:1 µm (dependent on design) |
| Minimum Bonding Size Features | 20 µm |
| Alignment Accuracy of Cavity to Alignment Marks | ± 3 µm |
| Cavity Depth | 1-30 µm @ +/-10% |
| 31-300 µm @ +/-20% | |
| Cavity Location | Handle, Device or Buried Oxide |
应用
